This article talks about SEE in complex devices. It mainly focuses on Single Event Burnout (SEB) in power MOSFETs and also touches on Single Event Upset (SEU) and Single Event Functional Interrupt (SEFI) in FPGAs. SEB in power MOSFETs is always accompanied by melting of metal layers on the front side of the device when a charged particle like a proton or an uncharged particle like a neutron hits a sensitive region in the MOSFET’s channel region which causes a forward bias in the source-body junction
Lors des tests de rayonnement visant à détecter les SEB dans les MOSFET de puissance, le composant est généralement bombardé par le dessus, car la zone sensible est généralement plus proche de la surface supérieure que de la surface inférieure de la puce. La couche supérieure est généralement recouverte de couches métalliques, ce qui facilite le passage des particules. Cependant, la profondeur de pénétration est limitée et, si le point sensible est plus profond que 100 mm, il sera difficile pour une particule d'énergie moyenne d'y parvenir. Les photons proches de l'infrarouge peuvent pénétrer une profondeur beaucoup plus importante de la puce, de l'ordre de quelques centaines de microns, mais ne peuvent pas traverser les couches métalliques. C'est pourquoi il est conseillé d'éclairer la puce décapsulée par sa face arrière, qui n'est pas recouverte de métal. Des mesures de sensibilité en profondeur à une tension fixe et à une énergie d'impulsion laser variable peuvent être effectuées pour déterminer la profondeur la plus sensible à laquelle le SEB se produit. La figure 2 présente les résultats de ces mesures (référence 1). Pour cette mesure, un laser à 1064 nm avec un spot de 4 mm a été utilisé. La profondeur de focalisation a été modifiée pour trouver l'énergie la plus basse à laquelle le SEB se produit pour une tension de polarisation particulière
Comme le montre la figure 2, différentes tensions de polarisation ont été utilisées et, pour chacune d'elles, l'énergie laser la plus faible déclenchant le SEB se produit à une profondeur de 340 mm. L'énergie laser requise diminue à mesure que la tension Drain-Source augmente, car le SEB se produit plus facilement à des tensions VDS plus élevées. Ce test est également utile pour estimer la profondeur de pénétration pour les tests de rayonnement. L'épaisseur de la puce étant de 430 mm, pour les tests de rayonnement effectués par la face avant, la particule doit atteindre une profondeur de 90 mm à partir du sommet. Il faut s'assurer que la particule possède suffisamment d'énergie pour atteindre cette profondeur.
Une autre mesure intéressante consiste à déterminer l'énergie laser minimale requise pour déclencher le SEB à une tension d'alimentation fixe. La figure 3 montre le résultat de cette mesure.
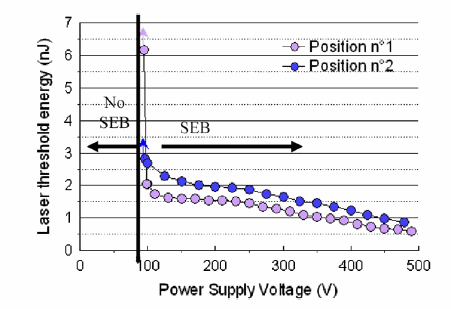
Figure 3 : Comportement asymptotique de l'énergie de seuil laser pour déclencher le SEB
Comme le montre la figure 3, à une tension de polarisation proche de 100 volts, quelle que soit l'énergie de l'impulsion laser, le SEB ne peut être déclenché. La courbe présente un comportement asymptotique. À mesure que la tension de polarisation augmente, l'énergie de l'impulsion laser nécessaire au déclenchement du SEB diminue, comme prévu. Les deux courbes sont légèrement décalées l'une par rapport à l'autre car elles représentent deux points différents sur la puce et la sensibilité de la structure est inégale (référence 1).
One can also do a 2D backside laser mapping of the chip at a fixed laser energy and varying voltages.
Les halos vert et bleu sont les zones les plus sensibles et représentent la zone du canal. Les noyaux rouge et jaune sont les parties les moins sensibles et représentent la zone du bouchon.
Lorsque les charges créées par une piste ionisante se déposent près du canal d'un MOSFET de puissance, elles provoquent une polarisation directe de la jonction source-corps, d'où l'apparition d'un SEB. En revanche, lorsque ces charges se déposent dans la zone de contact, les trous sont directement collectés au contact du corps et ne contribuent pas à la polarisation directe de la jonction source-corps. Ceci explique la sensibilité de la zone du canal et l'insensibilité de la zone de contact (référence 2).
It is also possible to compare the cross sections measured by a fixed laser energy as a function of bias voltage with the cross section of a fixed energy ion beam as a function of bias voltage
Les deux courbes coïncident quasiment, ce qui prouve la compatibilité des deux méthodes. Pour la méthode optique de mesure de section efficace décrite ci-dessus, l'énergie de l'impulsion laser était de 6 nj, tandis que pour la méthode de mesure de section efficace par rayonnement, un faisceau à LET élevé et de portée suffisante a été utilisé.
Les lasers pulsés proche infrarouge peuvent également être utilisés pour sonder la mémoire de configuration des FPGA afin d'y détecter des SEU et SEFI induits par laser. Dans une étude, un laser pulsé de 1 064 nm a été dirigé sur la mémoire de configuration d'un FPGA programmé pour une tâche particulière (référence 3). Non seulement l'impulsion laser a provoqué un SEU dans la mémoire de configuration, mais il a été constaté que 14 % des cellules ayant subi un SEU ont également perturbé la tâche à exécuter, provoquant ainsi un SEFI.
Allied Scientific Pro provides laser testing systems for probing Single Event Effect in space electronics. Both Single Photon Absorption (SPA) and Two Photon Absorption (TPA) systems are offered. The following link contains more information about the offered systems.
https://alliedscientificpro.com / shop/product/workstation-for-laser-testing-of-single-event-effects-see-on-radiation-hardened-semiconductor-devices-20868?search=SEE+laser+station
Le laser SPA est un laser à fibre de 1030 nm capable d'émettre des impulsions de l'ordre de la picoseconde et d'une énergie de l'ordre du nanojoule. Un laboratoire SPA est également disponible à la location. Il comprend un laser à fibre de 1030 nm, des caméras SWIR et visible, des contrôleurs de mouvement précis, des objectifs de microscope haute puissance et des illuminateurs.
Références :
1- Caractérisation de l'épuisement d'un événement unique dans un MOSFET de puissance à l'aide de tests laser arrière, F.Miller et.al, IEEE transactions on nuclear science, VOL.53, NO. 6, décembre 2006.
2- Caractérisation SEB de MOSFET de puissance commerciaux avec laser arrière et ions lourds de différentes gammes, A. Luu et.al, IEEE transaction on nuclear science, septembre 2008.
3- Tests laser pulsés pour les études sur les effets d'un événement unique, Stephen Buchner et.al, IEEE transactions on nuclear science, VOL.60, NO 3, juin 2013.